Effiziente NAND-Analyse mit AFM-in-SEM
Fehlererkennung direkt an der Quelle

In der modernen Halbleitertechnik ist die Fehlersuche in NAND-Speicherchips eine anspruchsvolle Aufgabe. Klassische Methoden stoßen hier schnell an ihre Grenzen – besonders, wenn es um präzise, tiefenaufgelöste Informationen zu lokalen Leitfähigkeitsausfällen geht.
Mit dem AFM-in-SEM-Ansatz von LiteScope lassen sich diese Herausforderungen direkt im Analyseprozess lösen – schnell, präzise und ohne Probenkontamination.
Was ist das Problem bei der NAND-Fehleranalyse?
NAND-Flashspeicher besteht aus komplexen, mehrschichtigen Strukturen. Ein Fehler in nur einer dieser Schichten kann zur vollständigen Funktionsstörung führen. Die zentrale Frage bei der Analyse lautet oft:
Wo genau liegt die Ursache eines Leitfähigkeitsausfalls – und auf welcher Ebene der Struktur?
Um dies herauszufinden, müssen einzelne Schichten gezielt abgetragen und direkt im Anschluss elektrisch untersucht werden. Genau hier setzt LiteScope an.
Die Lösung: In-situ Delayering (Entschichtung) und C-AFM-Messung
Mit dem LiteScope AFM-in-SEM-System kann die Analyse ohne Luftkontakt und ohne Umsetzen der Probe durchgeführt werden:
In-Situ Delayering (Entschichtung)
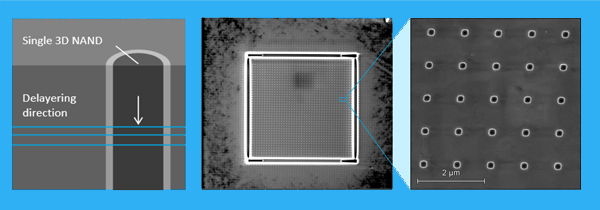
Der Workflow im Überblick:
- Gezieltes Delayering mit PFIB
– Selektives Abtragen einzelner Schichten auf definierte Tiefen (z. B. 5, 25, 50 nm …)
– Präzises Ansteuern von Transistoren oder Vias - In-situ C-AFM-Messung
– Direkt im Anschluss erfolgt die kontaktbasierte Messung der lokalen elektrischen Leitfähigkeit
– Kein Transfer, keine Oxidation, keine Zeitverluste - Ergebnis:
– Hochaufgelöste Stromkarten (Current Maps)
– I/V-Spektroskopie für tiefergehende Analysen
– Fehlerursachen können bis zur Einzelebene im NAND identifiziert werden
Warum AFM-in-SEM für die NAND-Analyse?
Die Kombination aus Rasterkraftmikroskopie (AFM) und Rasterelektronenmikroskopie (SEM) innerhalb eines Systems bietet entscheidende Vorteile:
Anwendungsrelevanz für Industrie, Forschung und Labore
Ob in Produktionsumgebungen, bei F&E oder in Forschungslaboren: Die NAND-Fehleranalyse mit LiteScope ermöglicht eine neue Qualität der nanoskaligen Fehlercharakterisierung – auch für komplexe oder „unsichtbare“ Fehler, die mit herkömmlichen Methoden nicht mehr erkennbar sind.
Durch den vollständig integrierten AFM-in-SEM-Ansatz wird die Fehleranalyse nicht nur zuverlässiger, sondern auch messbar effizienter.
– Blog –
Erfahren Sie mehr über dieses Produkt…


